TOF-SIMS飞行时间二次离子质谱的技术能力
飞行时间二次离子质谱 (TOF-SIMS) 是一种表面分析技术,它将脉冲一次离子束聚焦到样品表面,在溅射过程中产生二次离子。分析这些二次离子可提供有关样品表面的分子、无机和元素种类的信息。
例如,如果表面吸附了有机污染物(如油),TOF-SIMS将揭示这些信息,而其他技术则难以实现,特别是在污染物含量极低的情况下。由于TOF-SIMS是一种测量技术,因此通常可以检测到元素周期表中的所有元素,包括H。
此外,这种分析可以提供质谱信息;样品上XY维度的图像信息;以及Z 方向的深度剖面信息到样品中。

工作原理
飞行时间二次离子质谱法 (TOF-SIMS),又称静态 SIMS,是一种广泛用于表征表面和表面污染物的技术。它与动态SIMS密切相关,动态SIMS使用恒定的初级离子束在几分钟内蚀刻样品以形成溅射坑。相比之下,TOF-SIMS使用脉冲离子束,在分析时间尺度上不会显著溅射、蚀刻或损坏样品表面。这种无损伤使该技术成为分析表面存在元素(元素周期表中的大多数元素)和分子种类的理想技术,具有非常浅的采样深度(1-2nm)。结合飞行时间质谱仪,该技术提供了出色的测量能力,灵敏度在百万分之一 (ppm)范围内。TOF-SIMS仪器中使用一次离子束(通常69Ga 或197Au)可以聚焦到亚微米尺寸,这意味着该技术可用于分析1μm至500μm范围内的特征。无论导电样品还是绝缘样品都可以成功分析。
飞行时间二次离子质谱法(TOF-SIMS)的工作原理是将聚焦的一次离子脉冲光栅束光化到感兴趣的区域,从而产生与样品表面前几层材料特性相关的二级离子。通过准确测量检测到的离子质量,可以识别并确定样品表面存在的化学物质。获得的数据可以以质谱的形式或特定物质的离子图像的形式呈现。如果结合离子溅射(使用相同的一次离子枪或额外的 Cs、O 或 Ar 团簇离子束),也可以获得深度剖面图。
表面灵敏度
TOF-SIMS的高表面灵敏度使其成为解决问题的良好起点,可以对样品中存在的物质类型进行概述。然后可以使用其他技术来获取其他信息。TOF-SIMS还可以检测到比传统表面分析技术(如XPS和Auger)低得多的物质水平。
TOF-SIMS的数据集可能非常复杂,并且可能比其他方法需要更多的解释或数据处理。TOF-SIMS的成像能力可以提供微米级的缺陷和颗粒的元素和分子信息。TOF-SIMS也可用于深度剖析,并与动态SIMS互补。剖面分析的优势在于其小面积的处理能力,以及无需选择特定元素即可进行全面深度剖面分析的能力。簇离子束使有机材料的剖面分析成为可能,同时保持结构上的重要信息。
使用TOF-SIMS可以进行质量控制,故障分析,故障排除,过程监控和研发。例如,我们在调查晶圆表面污染问题时提供的信息可以帮助确定问题的具体来源,例如泵油或组件脱气,或者可能表明晶圆加工步骤本身存在问题(例如蚀刻残留)。

TOF-SIMS是SMART图谱的一部分,是一种对表面非常敏感的技术,可提供全面的元素和分子分析,具有出色的检测限
典型数据


氟碳膜显示硅污染 清洁全氟碳膜,不含硅

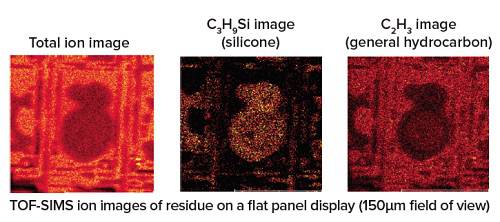
污染硅晶圆上铁(Fe)的高质量分辨率光谱与清洁硅晶圆的比较 平板显示器上残留物的TOF-SIMS离子图像(150微米视野)
TOF-SIMS的理想用途
- 其出色的表面灵敏度、分析有机材料和其他绝缘体的能力、极低的检测限以及提供元素和分子信息的能力,使TOF-SIMS成为解决以下类型应用的理想技术:
- 有机和无机材料的表面分析
- 有机材料和元素材料的表面特性分析
- 表面物质的横向分布图绘制
- 元素或分子物质的污染识别(ppm范围内)
- 晶圆上表面金属的定量分析
- 粘附、焊垫、涂层等的失效分析
- 清洁过程评估 (QA/QC)
- 识别污渍、变色和雾霾
- 加工前后表面的对比以识别差异
- 在不同环境中加工或存储的样品之间的表面变化比较 表面元素和分子的成像
- 剥离、起泡、脱湿、污渍、雾等的失效和根本原因分析
- 调查深度剖析
TOF-SIMS的优势
- 表面灵敏:前几个单层
- ppm 范围内的检测限
- 调查分析
- 调查深度剖面图
- 元素和分子信息
- 可分析绝缘体和导体
- 成像模式下可实现亚微米级的空间分辨率
- 某些应用中可获得主要元素组成
TOF-SIMS的局限性
- 定量需要大量的校准数据,难度较大
- 对表面敏感,因此样品处理/包装时要小心谨慎
- 样品必须与真空兼容 数据集可能很复杂
技术比较
其他具有相似分析深度或应用的表面分析工具包括 X 射线光电子能谱 (XPS)、俄歇电子能谱(AES) 和傅里叶变换红外光谱(FTIR)。XPS提供定量浓度和化学键信息,这些信息通常无法直接使用TOF-SIMS获得。AES可以为元素种类提供更好的空间分辨率图像,但灵敏度较差。FTIR可以提供互补的有机信息,具有更深的信息深度和访问商业光谱库的能力。这可能使FTIR成为识别宏观材料量的更好选择,因为极端表面信息可能并非首要关注点。
那诺中国提供的TOF-SIMS飞行时间二次离子质谱仪(型号:SurfaceSeer I)具有高空间分辨率成像能力,可用于绝缘、导电表面的成像分析与化学成分分析。SurfaceSeer I 是研究表面化学的理想选择,适用于研发和工业质量控制应用,并且具有较高的性价比。
TOF-SIMS技术规格
- 信号检测:元素离子和分子离子
- 检测元素:完全覆盖元素周期表,以及分子种类
- 检测限:单分子层的几分之一,107至1010at/cm2(金属在半导体上),深度剖面中体积浓度低至 1 ppm
- 深度分辨率:1-3 个单层(静态模式),低至 1 nm(深度剖析)
- 信息深度:低于 1 nm(静态模式), 10 μm(深度剖析)
- 成像/映射:是
- 横向分辨率/探头尺寸:低至 0.2 μm





